【破壞性分析】
掃描式電子顯微鏡掃描電子顯微鏡(Scanning Electron Microscope, SEM)是表面微細結構觀察最快速有效的方法,掃描式電子顯微鏡是利用微小聚焦的電子束(Electron Beam)進行樣品表面掃描,以收集二次電子的訊號來成像。訊號源主要來自:二次電子、背向散射電子及特性X光等。SEM可提供樣品表面高解析度且長景深的圖像。極利於微小區域的觀察。同時結合EDS(X-射線能量散布能譜)的元素成分分析 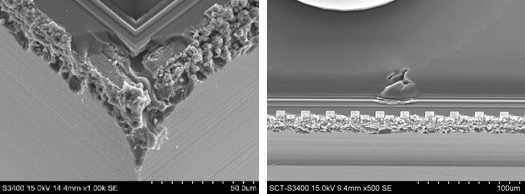
|

|
12”晶圓級雙束聚焦離子束12吋晶圓級雙束聚焦離子束 (Dual Beam FIB)機台能在使用離子束切割樣品的同時,用電子束對樣品斷面進行觀察,亦能進行EDX的成份分析。 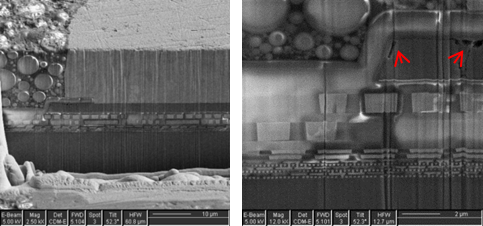
|

|
切片破壞分析用混合膠填滿樣品周圍縫隙,以增強樣品結構強度,避免因承受研磨應力而樣品毀損。樣品以不同粗細之砂紙,在特定區域(定點)或非特定區域(非定點)進行研磨後觀察。 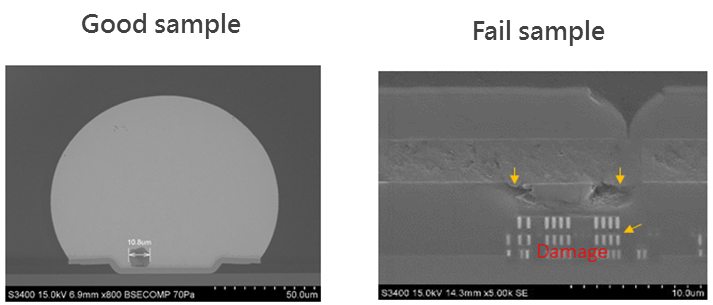
|
化性破壞分析利用蝕刻液進行濕式蝕刻,執行開蓋(Decap)、去膠(去除封膠,Compound Removal)、取出晶粒、去錫球等步驟,觀察封膠體內晶片或元件異常問題(如:打線異常,晶片Crack,chipping,刮痕....等)。 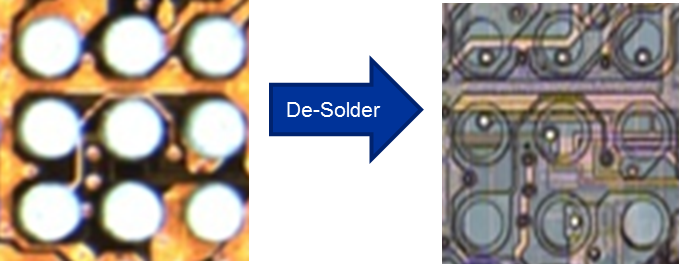
|