晶背金屬化
因應高速率運算所產生的熱效應,可利用裸晶背面披覆金屬層的方式來加快其導熱效率,較之傳統的Epoxy Molded 封裝晶粒其散熱效率有更好的表現。
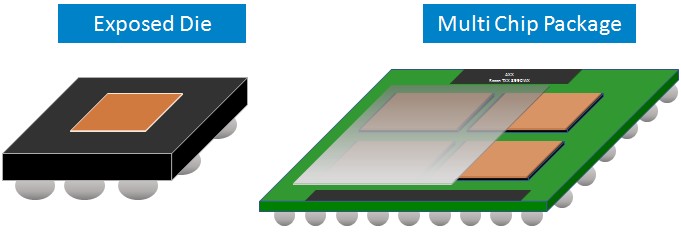
應用
PMIC, High Performance Computing, AIoT Edge Computing, Cryptocurrency, Heat Sink, EMI Shield…etc

規格 & 能力
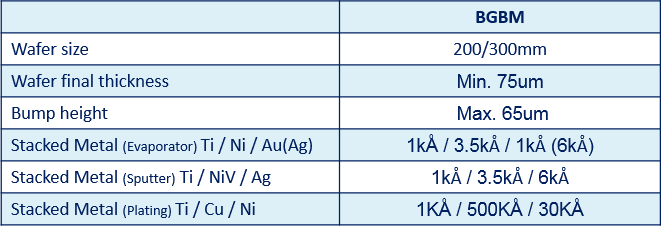
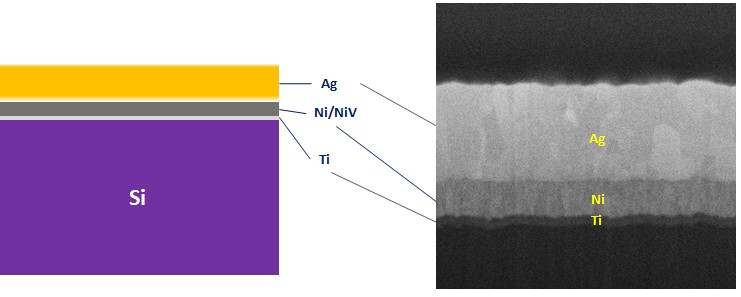
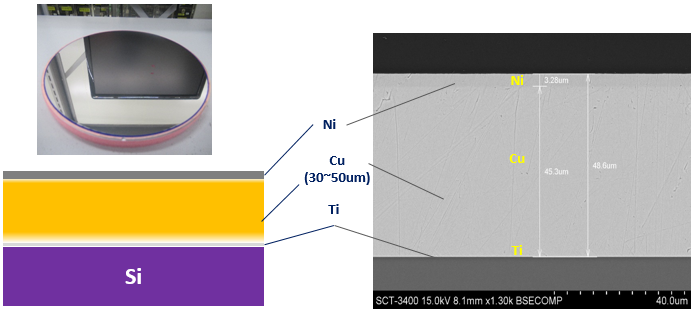
晶背 黃光對準
利用晶圓背面黃光製程將背面金屬圖形轉移至晶背,且與正面活動區電路對齊,切割道也可透由該過程去除金屬,已達到更好的切割品質
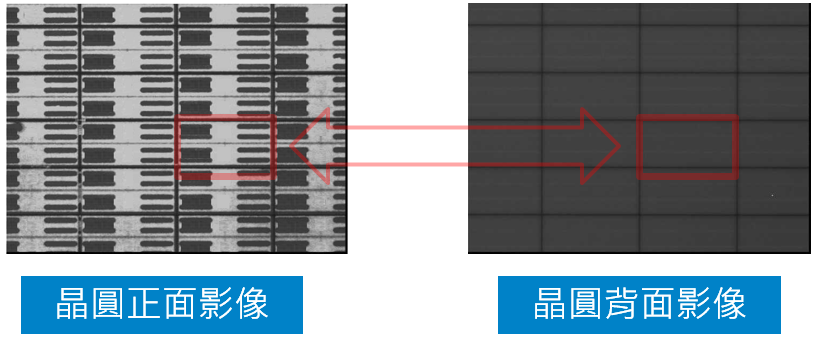

晶背金屬化 製程流程
